В лаборатории с использованием современного метода XAFS-спектроскопии изучается влияние микроскопической структуры и различных примесей на физические свойства полупроводников, сегнетоэлектриков и изготовленных из них низкоразмерных структур (нанопластинок, квантовых точек).
Метод XAFS-спектроскопии основан на изучении тонкой структуры спектров поглощения в рентгеновской области. Он нашел широкое применение в различных областях науки и применим к изучению материалов во всех агрегатных состояниях. Измерения спектров XAFS проводятся на источниках синхротронного излучения в нашей стране, в том числе в Курчатовском институте, и за рубежом.
Проводимые в лаборатории исследования носят комплексный характер, включают в себя рентгеновские, оптические, электрические и магнитные измерения. При анализе полученных результатов используются данные расчетов, выполненные из первых принципов (ab initio). Полученные данные используются для поиска новых материалов со свойствами, перспективными для создания оптоэлектронных и фотокаталитических устройств.
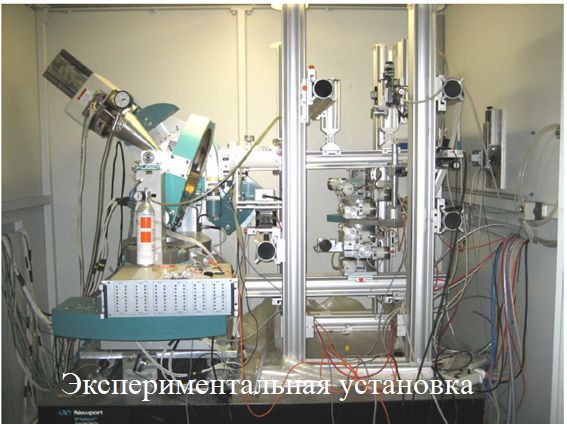

Результаты исследований неоднократно докладывались на международных и российских конференциях, а также публиковались в ведущих российских и зарубежных журналах.


